
КАТЕГОРИИ:
АстрономияБиологияГеографияДругие языкиДругоеИнформатикаИсторияКультураЛитератураЛогикаМатематикаМедицинаМеханикаОбразованиеОхрана трудаПедагогикаПолитикаПравоПсихологияРиторикаСоциологияСпортСтроительствоТехнологияФизикаФилософияФинансыХимияЧерчениеЭкологияЭкономикаЭлектроника
Перспективные структуры для дальнейшего повышения быстродействия МОПТ
Для разработки МОПТ с длиной канала менее 100 нм в соответствии с правиламимасштабирования необходимо уменьшать глубину залегания p-n-переходов и толщину окисла. Однако для транзисторов с длиной канала менее 100 нм ток туннелирования через затвор становится очень большим и ограничивает мощность, потребляемую СБИС в режиме покоя, а мелкие p-n-переходы приводят к большому сопротивлению контактных областей. Для предотвращения смыкания областей истока и стока неизбежно применение высоколегированного (>1018 см-3) стопора. Однако стопор снижает нагрузочную способность транзистора и увеличивает утечки в подпороговой области.
В связи с изложенным, появился большой интерес к транзисторам с двойным или окольцовывающим затвором, когда затвор с двух (или со всех) сторон охватывает область канала. Такой подход позволяет эффективно управлять энергетическим барьером между истоком и стоком и существенно ослабить большинство короткоканальных эффектов в транзисторах с проектными нормами менее 50 нм. Уменьшается также ёмкость р-n-переходов, улучшенная радиационная стойкость. Двойная плотность заряда инверсионного слоя увеличивает нагрузочную способность транзистора.
Принцип действия транзистора DELTA с двойным затвором иллюстрируется на рис.4.28. На толстом слое окисла создаётся островок кремния в форме бруска, который служит каналом транзистора. Затвор охватывает область канала с трёх сторон. Это обеспечивает большую крутизну и малые токи утечки в подпороговой области. Канал транзистора получается сильно обеднённым. Транзистор работает в режиме объёмной инверсии полупроводника. С уменьшением его толщины наблюдается увеличение наклона подпороговой характеристики, то есть уменьшение тока утечки в подпороговой области. Это объясняется уменьшением ёмкости обеднённого слоя и, следовательно, увеличением потенциала поверхностного слоя. В транзисторах с очень тонким каналом (2 нм) становится существенным эффект квантования энергии, который влияет на функцию распределения электронов в полупроводнике и параметры транзистора. Увеличивается также роль рассеяния носителей на шероховатостях границы раздела окисел-кремний, поскольку увеличивается площадь затвора.
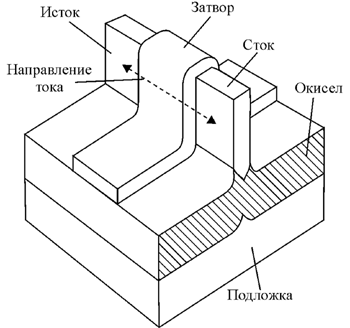
Рисунок 4.28 – Структура МОПТ с двойным затвором
Структура транзистора с двойным затвором в настоящее время существенно модернизирована для обеспечения лучшей технологичности и совместимости с существующими техпроцессами массового производства. Транзистор имеет толщину окисла 2,5 нм и длину канала до 10 нм, высота канала составляет 50 нм, толщина - от 10 до 120 нм. Конструкция транзистора разработана таким образом, что его топология не отличается от обычного интегрального МОПТ. Однако особенностями конструкции является самосовмещённость затворов друг с другом и с областями истока и стока, затвор выполнен из SiGe, низкоомные областям истока и стока выполнены из поликремния или поли-Si0,85Ge0,15, легированного фосфором.
В транзисторах с окольцовывающим затвором (рис. 4.29) ток канала течёт перпендикулярно поверхности кристалла, и затвор со всех сторон окружает канал (Surrounding Gate Transistor, SGT). Такая структура обеспечивает минимальную ёмкость обеднённого слоя и поэтому практически весь заряд затвора уравновешивается зарядом носителей в канале и тонком обеднённом слое. Поэтому такая структура имеет минимальные подпороговые токи и большую крутизну. Вертикальное расположение канала обеспечивает высокую степень интеграции. Это позволяет использовать транзисторы с окольцовывающим затвором для построения ячеек памяти статических, динамических и электрически программируемых запоминающих устройств.
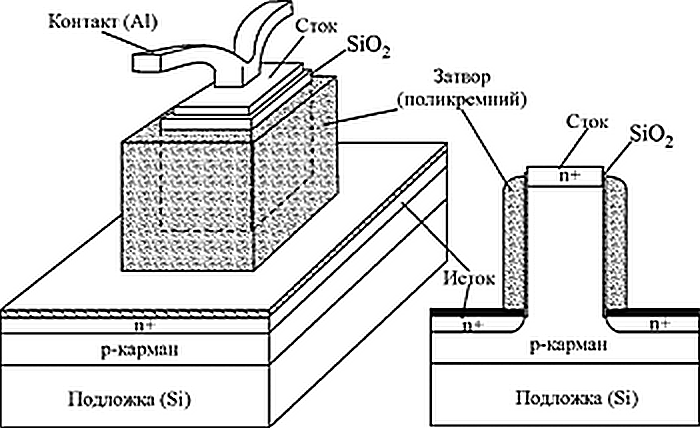
Рисунок 4.29 – МОПТ с цилиндрическим каналом. Справа показано поперечное сечение структуры
Недостатками описанных конструкций являются высокое тепловое сопротивление между каналом и подложкой, которое вызывает сильный саморазогрев и, как следствие, увеличенное рассеяние носителей на фононах, а также увеличенное паразитное последовательное сопротивление областей истока и стока.
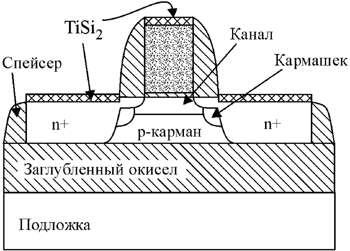
Рисунок 4.30 – КНИ-структура
МОПТ, изготовленные по технологии "кремний на изоляторе" (КНИ), являются весьма перспективными для создания микромощных и высокоскоростных СБИС с напряжением питания до 1,2 В и менее, поскольку наличие толстого окисла вместо кремния под областями истока и стока существенно уменьшает величину ёмкости на подложку. Вторым преимуществом является простой процесс изоляции компонентов и высокая плотность интеграции благодаря отсутствию изолирующих карманов. КНИ-структуры отличаются высокой радиационной стойкостью и повышенной надёжностью при высоких температурах. Короткоканальные эффекты в КНИ-приборах могут быть подавлены простым уменьшением толщины кремниевого слоя. Наклон подпороговой характеристики у КНИ-транзисторов получается практически идеальным. Транзисторы высокого качества получаются на плёнках кремния толщиной 8 нм.
Однако перспективность КНИ-структур не является бесспорной. Основная проблема состоит в том, что КНИ-транзисторы имеют увеличенный подпороговый ток вследствие эффекта плавающей подложки, который устанавливает предел понижению потребляемой мощности в выключенном состоянии транзисторного ключа. Попытка понизить этот ток приводит к увеличению порогового напряжения, которое не позволяет уменьшить напряжение питания для уменьшения потребляемой мощности. Вторым принципиальным аргументом является то, что малая собственная ёмкость КНИ-транзистора перестаёт быть его преимуществом при дальнейшем сокращении размеров, поскольку уже в современных СБИС задержка в межсоединениях превышает задержку в вентилях.
Одной из проблем изготовления транзисторов на тонких плёнках кремния является высокое последовательное сопротивление областей истока и стока. Для его уменьшения используют самосовмещённый силицидный процесс, использующий силицид титана или кобальта. Однако, если толщина используемой плёнки кремния менее 20 нм, то такой тонкий слой может быть полностью поглощён формирующимся слоем силицида и тогда площадь контакта между кремнием и силицидом резко уменьшается, что приводит к возрастанию сопротивления контакта. Очень малое поглощение кремния происходит при выполнении контакта из вольфрама, однако при контакте к сильнолегированному кремнию р-типа проводимости вольфрам образует контакты с очень плохой стабильностью характеристик. Для решения проблемы контактов может потребоваться эпитаксиальное наращивание плёнки кремния сверху областей истока и стока или, наоборот, стравливание той области кремния, где должен быть сформирован канала транзистора.
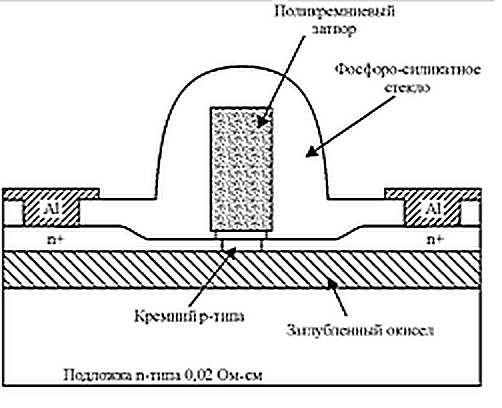
Рисунок 4.31 – КНИ с ультратонким слоем кремния
Транзисторы с вертикальным каналом предлагаются в качестве кандидатов на субмикронные структуры. Изготовление канала в вертикальном направлении снижает площадь кристалла, но позволяет делать канал длинным и избавиться таким образом от короткоканальных эффектов, в частности, уменьшить подпороговый ток, что особенно важно для ячеек памяти.
Транзистор с тройным затвором (П-образный транзистор) является конструктивной модификацией транзистора с двойным затвором. В нём затвор охватывает канал не с двух сторон, и не окольцовывает его, а управляет каналом с прямоугольным сечением с трёх сторон, напоминая в сечении греческую букву "П". Эта конструкция более технологична, чем с окольцовывающим затвором.
Для решения проблемы уменьшения подвижности в транзисторах с коротким каналом изучается применение механически напряжённого кремния, который выращивается на поверхности SiGe. Вследствие различия в постоянных кристаллической решётки Si и SiGe кремний испытывает механическое растягивающее усилие по двум координатам. Было обнаружено, что подвижность носителей в напряжённом кремнии выше, чем в обычном и при 30-% содержании Ge в SiGe подвижность электронов в напряжённом кремнии увеличивается примерно на 80%.
Одним из путей уменьшения потребляемой мощности ИС является снижение напряжения питания. Однако оно не может быть меньше величины учетверённого порогового напряжения. В то же время пороговое напряжение не может быть уменьшено ниже 0,2 В, поскольку это приводит к увеличению подпорогового тока, который определяет потребляемую мощность в пассивном режиме СБИС. Решить это противоречие позволяют МОПТ с динамически изменяющимся пороговым напряжением (DTMOS). При уменьшении напряжения на затворе (то есть когда транзистор переходит в пассивный режим работы) у таких транзисторов увеличивается пороговое напряжение и, следовательно, уменьшается подпороговый ток. При увеличении напряжения на затворе пороговое напряжение падает, что приводит к росту тока стока и увеличению нагрузочной способности транзистора. Конструктивно DTMOS-транзисторы представляют собой обычный КНИ МОП-транзистор, у которого затвор соединён с подложкой. При этом пороговое напряжение управляется напряжением на подложке, которое автоматически уменьшается с ростом напряжения на затворе. Недостатком такого транзистора является малое напряжение питания (0,6 В), ограниченное напряжением отпирания p-n-переходов истока и стока.
Дата добавления: 2014-11-13; просмотров: 159; Мы поможем в написании вашей работы!; Нарушение авторских прав |