
КАТЕГОРИИ:
АстрономияБиологияГеографияДругие языкиДругоеИнформатикаИсторияКультураЛитератураЛогикаМатематикаМедицинаМеханикаОбразованиеОхрана трудаПедагогикаПолитикаПравоПсихологияРиторикаСоциологияСпортСтроительствоТехнологияФизикаФилософияФинансыХимияЧерчениеЭкологияЭкономикаЭлектроника
Диоды Ганна. Эффект Ганна. Особенности многодолинных полупроводников.
Механизм образования отрицательной дифференциальной проводимости. Домены сильного поля и механизм их
Диод Ганна (ДГ) – полупроводниковый прибор с отрицательным дифференциальным сопротивлением, возникающим в объеме однородного полупроводника при приложении к нему сильного электрического поля. ДГ представляют собой полупроводниковую структуру, состоящую из слоя полупроводника с электронной проводимостью толщиной от единиц до десятков микрометров, заключенного между невыпрямляющими контактами катодом и анодом (рис.3.15).
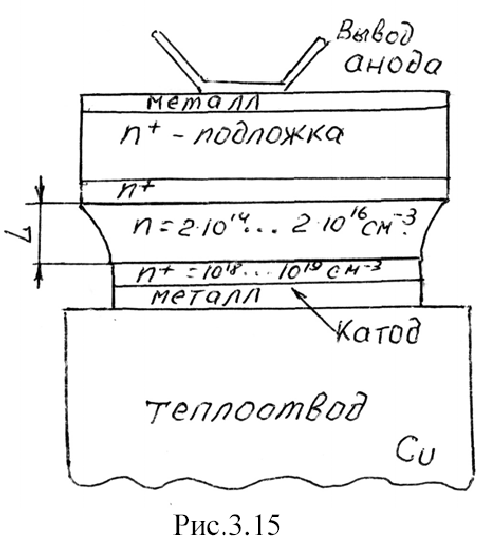
В качестве материала структуры используется обычно арсенид галлия (GaAs) n-типа, возможно применение фосфида индия (InP). Отрицательное дифференциальное сопротивление диода Ганна является следствием эффекта междолинного переноса электронов, характерного для многодолинных полупроводников, имеющих в зоне проводимости несколько областей (долин).
На рис.3.16 изображена зонная диаграмма арсенида галлия n-типа (n-GaAs) - основного материала, используемого для изготовления ДГ. Электроны в зоне проводимости могут находится в одной из долин, разделенных энергетическим зазором ∆= 0,36 эВ. Электроны, находящиеся в нижней долине, обладают малой эффективной массой m1* = 0,07mo, где mо = 9,1×10 -31 кг - масса свободного электрона, и большой подвижностью m1 = V/Е, находящиеся же в верхней долине имеют значительно большую эффективную массу m2* = 1,2mo и как следствие - значительно меньшую подвижность.
 В состоянии термодинамического равновесия, т.е. в отсутствии внешнего воздействия, концентрация электронов n1 и n2 в нижней и верхней долинах подчиняются закону Больцмана
В состоянии термодинамического равновесия, т.е. в отсутствии внешнего воздействия, концентрация электронов n1 и n2 в нижней и верхней долинах подчиняются закону Больцмана
n1/n2=A e-∆/(kT), (3.16) где k = 1,38×10-23 Дж/град - постоянная Больцмана, А = N1/N2, (A=70 для GaAs), N1, N2 - плотности энергетических состояний в долинах.
При комнатной температуре Т = 300 К согласно (3.16) n2/n1 = 7×10-5, т.е. практически все электроны зоны проводимости находятся в нижней долине. Положение меняется при прикладывании к диоду напряжения Uо. С увеличением U0 возрастает напряженность электрического поля Е =U0/L (L – длина активной области диода) и энергия электронов, что эквивалентно возрастанию температуры Т. В результате возрастает число электронов
проводимости, переходящих из нижней долины в верхнюю.
Средняя дрейфовая скорость электронов при любом значении Е определяется как средняя арифметическая скорость электронов нижней (V1) и
верхней (V2) долин

График зависимости скорости электронов от напряженности электрического поля V(Е) для n-GaAs приведен на рис.3.17. При Е < Епор почти все электроны зоны проводимости находятся в нижней долине n = n1 + n2 = n1, n=0 . Согласно (3.17) V = µE, т.е. зависимость V(Е) имеет линейный характер.
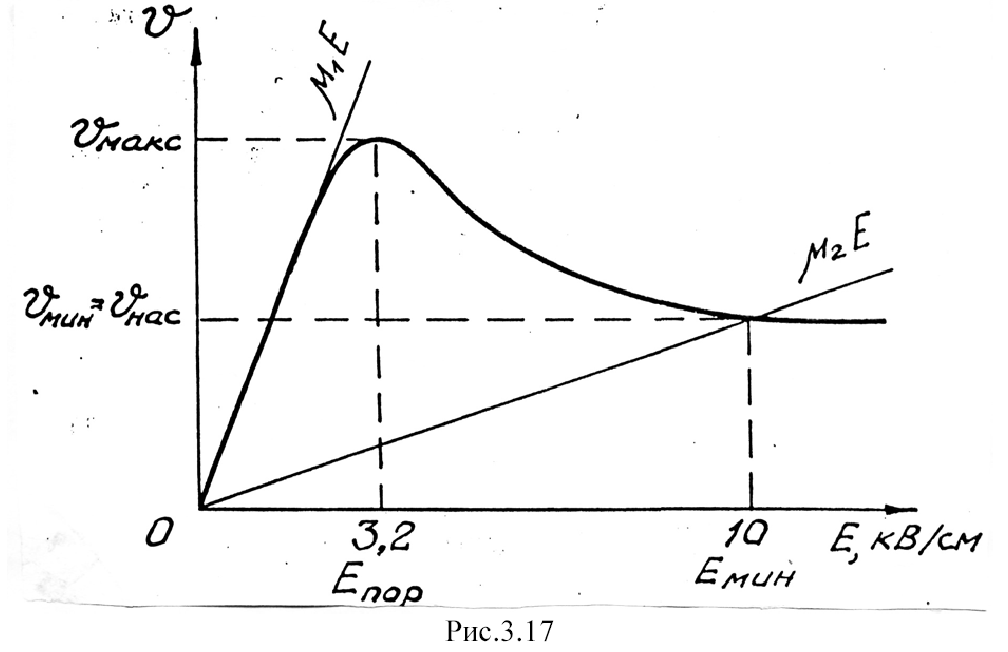 С увеличнием напряжености поля Е все большее число электронов переходит в верхнюю долину (n2 - возрастает, n1 - уменьшается), при Е > Епор этот процесс происходит настолько резко, что происходит уменьшение средней дрейфовой скорости электронов V. Напряженность поля, соответствующая максимальной скорости Vмакс, называют пороговой (или критической)
С увеличнием напряжености поля Е все большее число электронов переходит в верхнюю долину (n2 - возрастает, n1 - уменьшается), при Е > Епор этот процесс происходит настолько резко, что происходит уменьшение средней дрейфовой скорости электронов V. Напряженность поля, соответствующая максимальной скорости Vмакс, называют пороговой (или критической)
Из (3.17) следует, что при Е > Eпор, когда n2=n и n1=0, зависимость V(Е) снова должна стать линейной: V = µ2E. В действительности при сильных полях Е > Eпор взаимодействие электронов с кристаллической решеткой приводит к насыщению скорости электронов, поэтому V = Vнас = const. Крутизну падающего участка зависимости V(Е) характеризуют дифференциальной подвижностью
µ3 = dV/dE < 0, (3.18)
Плотность электронного тока в однородном полупроводнике пропорциональна средней дрейфовой скорости электронов:
j = GE = e(µ1n1 + µ2n2)E = e(n1 + n2)V, (3.19)
где G- удельная проводимость полупроводника.
При n0 = n1 + n2 = const во всем объеме полупроводника уменьшение скорости электронов с увеличением напряженности поля (dV/dЕ < 0) равносильно уменьшению плотности тока (dj/dE < 0) и следовательно является причиной возникновения в полупроводнике состояния отрицательной дифференциальной проводимости (G < 0).
Полупроводник, обладающий отрицательной дифференциальной проводимостью имеет следующее свойство: если в объеме кристалла полупроводника возникает произвольная флуктуация концентрации носителей заряда ∆n, избыточная по отношению равновесной концентрации и no, то в той области кристалла, где возникла эта флукциация, начнется нарастание пространственного заряда в пространстве и во времени , что приведет к
неустойчивости распределения электрического поля в кристалле при постоянном приложенном напряжении
U > Uпор = Епор×L.
Для более подробного рассмотрения этого свойства обратимся к рис.3.18, который иллюстрирует развитие неустойчивости электрического поля в однородном полупроводнике, обладающем отрицательной дифференциальной проводимостью. Предположим, что при приложении к ДГ напряжения Uo из катода в однородный полупроводник инжектируются электроны, в результате чего в пределах небольшого участка х возникает неоднородность, в виде слоя накопления, в которой количество электронов n > no (рис. 3.18,а). Распределение поля Е(х) связано с распределением заряда n(x) - no уравнением Пуассона:

 , где ε - диэлектрическая проницаемость.
, где ε - диэлектрическая проницаемость.
Там, где n = n0 ∂E/∂x = 0 и поэтому Е = const. В области же, где n > no, ∂E/∂x > 0, т.е. напряженность поля Е(х) возрастает.
Поскольку напряжение U=  , а в области неоднородности ∂E/∂x > 0 напряженности поля Е1 и Е2 окажутся разными: Е1 < Eср = U/L < E2. Если Еср соответствует падающему участку (рис.3.18,в), скорость электронов V1(E1) > V2(E2), заряд движущегося к аноду слоя будет пополняться за счет электронов, поступающих со стороны катода.Увеличение же заряда приведет к увеличению ∂E/∂x в слое и как следствие, к увеличению разности полей Е2 - Е1 (рис.3.18,б). Рост Е2 и уменьшение Е1 будут продолжаться до тех пор, пока растущий слой объемного заряда не исчезнет, достигнув анодного контакта. Затем процесс накопления, перемещения растущего заряда и его рассасывания будет периодически повторяться, причем период равен времени движения заряда через кристалл Т = L/Vнас. При этом будут наблюдаться периодические колебания тока во внешней цепи диода Ганна. В зависимости от длины активной области диода L, концентрации носителей n возможны и другие виды неустойчивости тока в образце GaAs при постоянном приложенном напряжении Uo. Явление возникновения колебаний тока в однородном образце n-GaAs часто называется эффектом Ганна.
, а в области неоднородности ∂E/∂x > 0 напряженности поля Е1 и Е2 окажутся разными: Е1 < Eср = U/L < E2. Если Еср соответствует падающему участку (рис.3.18,в), скорость электронов V1(E1) > V2(E2), заряд движущегося к аноду слоя будет пополняться за счет электронов, поступающих со стороны катода.Увеличение же заряда приведет к увеличению ∂E/∂x в слое и как следствие, к увеличению разности полей Е2 - Е1 (рис.3.18,б). Рост Е2 и уменьшение Е1 будут продолжаться до тех пор, пока растущий слой объемного заряда не исчезнет, достигнув анодного контакта. Затем процесс накопления, перемещения растущего заряда и его рассасывания будет периодически повторяться, причем период равен времени движения заряда через кристалл Т = L/Vнас. При этом будут наблюдаться периодические колебания тока во внешней цепи диода Ганна. В зависимости от длины активной области диода L, концентрации носителей n возможны и другие виды неустойчивости тока в образце GaAs при постоянном приложенном напряжении Uo. Явление возникновения колебаний тока в однородном образце n-GaAs часто называется эффектом Ганна.
Дата добавления: 2015-02-10; просмотров: 566; Мы поможем в написании вашей работы!; Нарушение авторских прав |